时间:2024-05-19 09:14
人气:
作者:admin
MBIST是Memory Build-In-Self Test的简称,意为存储器内建自测试。“内建”的含义是指针对存储器的测试向量不是由外部测试机台(ATE:Auto-Test-Equipment)生成,而是由内建的存储器测试逻辑自动产生,并进行结果的对比。MBIST测试中,只需要从机台通过JTAG标准接口下达测试的指令,就可以从TDO接口获取测试结果。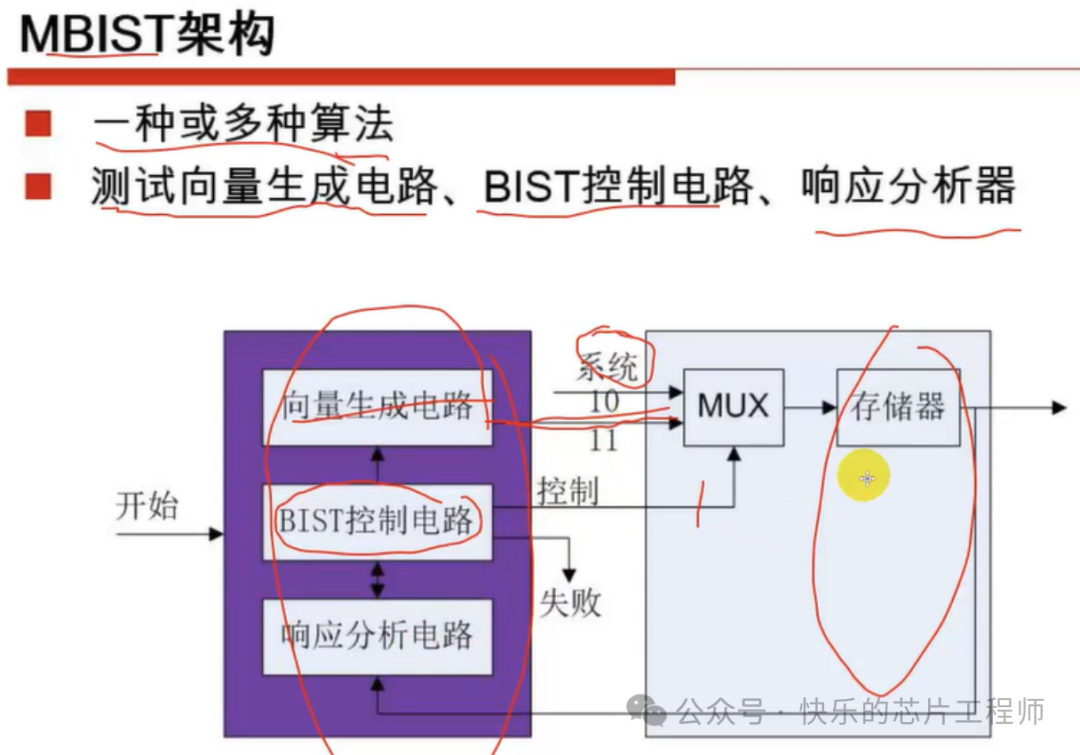
为什么要进行内建自测试呢?原因主要有:
a)存储器在很小的面积内集成了很多存储单元,对ATE的测试成本过高,不适用于从外部灌入针对存储器的测试向量;
b)Memory测试的特殊性——需要测试的单元很多,但分布规整,可利用算法批量产生测试向量;
c)在线测试的需求——汽车电子的安全性,需求在芯片运行时仍保持在线测试(即不依赖测试机台,可集成于板级、芯片内或由软件调用,来实现随时随需的测试),随时排除可能出现的故障。
因此我们可总结出内建自测试的优势:因为测试向量由内部逻辑生成,相应模块可同被测试的存储器一同工作在内部的高速功能时钟下,而无需由机台慢速时钟移入测试向量,可节省大量的测试时间;另一方面,对比验证也同样交给内部逻辑自行完成,测试机台只需要收集测试结果,也可大幅减少测试时间。代价是内建自测试的逻辑对面积的占用很高,也不具备自由配置或更改测试向量的条件。
MBIST技术的缺点是增加了芯片的面积并有可能影响芯片的时序特性,然而,随着存储器容量的增加,这种方法所增加的芯片面积所占的比例相对很小,而且这种测试技术还有很多其它技术优势。首先它可以实现可测性设计的自动化,自动实现通用存储器测试算法,达到高测试质量、低测试成本的目的;其次MBIST电路可以利用系统时钟进行“全速”测试,从而覆盖更多生成缺陷,减少测试时间;最后它可以针对每一个存储单元提供自诊断和自修复功能。
此外MBIST的初始化测试向量可以在很低成本的测试设备上进行。所以,从高测试质量、低测试成本的角度考虑,MBIST是目前嵌入式存储器测试设计的主流技术。
下一篇:MK工业级eMMC智慧存储