时间:2023-09-28 15:29
人气:
作者:admin
先进封装技术以SiP、WLP、2.5D/3D为三大发展重点。先进封装核心技术包括Bumping凸点、RDL重布线、硅中介层和TSV通孔等,依托这些技术的组合各厂商发展出了满足多样化需求的封装解决方案,SiP系统级封装、WLP晶圆级封装、2.5D/3D封装为三大发展重点。
1.Bumping(凸点)
Bumping工艺被称为中道工序,是先进封装的核心技术之一。 Bumping通过高精密曝光、离子处理、电镀等设备和材料,基于定制的光掩模,在晶圆上实现重布线,允许芯片有更高的端口密度,缩短了信号传输路径,减少了信号延迟,具备了更优良的热传导性及可靠性。
主流的凸块工艺均采用晶圆级加工,即在整块晶圆表面的所有芯片上加工制作凸块,晶圆级凸块工艺包括蒸发方式、印刷方式和电镀方式三种,目前业界广泛采用的是印刷方式和电镀方式。晶圆代工厂在凸块工艺方面具有一定优势。

2.RDL(ReDistribution Layer,重布线层)
RDL主要为 2D 平面上的芯片电气延伸与互连提供媒介。 芯片的 I/O 触点通常分布在边沿或者四周,直接进行芯片倒装会因缺少引线或引线过于密集而导致连接受限,RDL则可将这些触点重新布局到占位更为宽松的区域,并形成面阵列排布,以此减少后续的封装或表面贴装的难度。RDL 的优势主要有三点:
1)芯片设计者可以通过对 RDL 的设计代替一部分芯片内部线路的设计,从而降低设计成本;
2)采用RDL能够支持更多的引脚数量;
3)采用RDL可以使I/O触点间距更灵活、凸点面积更大,从而使基板与元件之间的应力更小、元件可靠性更高。
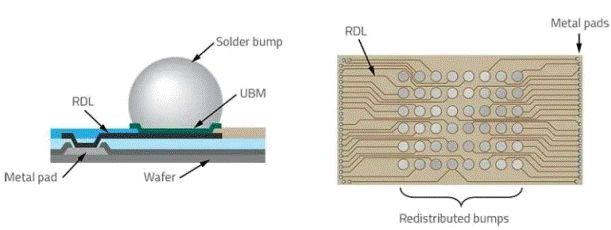
3.Interposer(硅中介层)
硅中介层是封装中多芯片模块或电路板传递电信号的连接平台 。Interposer 通过引线凸块/TSV实现电气连接 ,它可以由硅和有机材料制成,充当多颗裸片和电路板之间的桥梁,完成异质集成封装。
Interposer 具有较高的细间距 I/O 密度和 TSV 形成能力,在 2.5D 和 3D IC 芯片封装中扮演着关键角色。与 RDL 用于单颗芯片的重布线不同的是, Interposer 主要用于连接多颗芯片与下方基板。
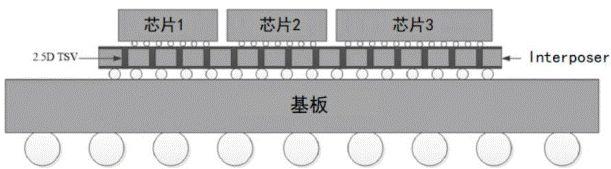
4.TSV(Through Silicon Via,硅通孔 )
TSV是2.5D/3D 封装解决方案的关键实现技术。 TSV 是一种垂直互连技术,目前最广泛的是在晶圆中填充以铜,提供贯通硅晶圆裸片的垂直互连,用最短路径将硅片一侧和另一侧进行电气连通。 TSV 的尺寸多为 10 μ m × 100 μ m 和30 μ m × 200 μ m ,开口率介于 0.1%-1% 。
相比平面互连, TSV 可减小互连长度和信号延迟,降低寄生电容和电感,实现芯片间的低功耗和高速通信,增加宽带和实现封装小型化。
当前 TSV 主要用于硅转接板、芯片三维堆叠等方面。其中,硅转接板作为芯片和有机基板的中间层,因与硅芯片的热膨胀系数相同,在硅转接板上可集成多颗具有高密度凸点的芯片。