时间:2023-08-18 09:55
人气:
作者:admin
一、半导体封装技术简介
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
尤其以引线键合(Wire Bonding)及倒装连接(Flip Chip Bonding)最为常见,因为载带连接技术(TAB)有一定的局限性,封装上逐渐淘汰了这种技术。
倒装芯片技术是通过芯片上的凸点直接将元器件朝下互连到基板、载体或者电路板上。引线键合的连接方式是将芯片的正面朝上,通过引线(通常是金线)将芯片与线路板连接。
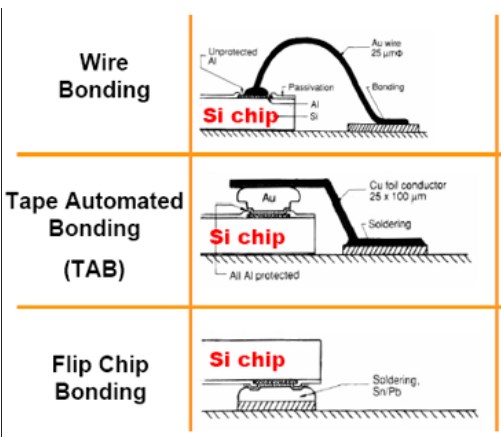
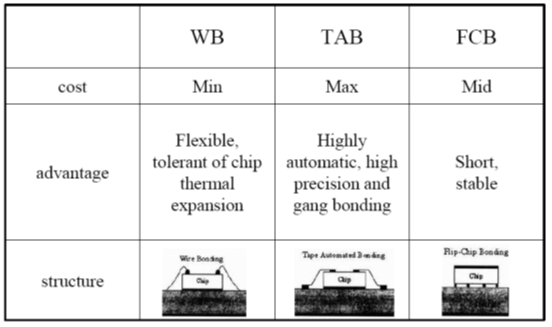
引线键合、载带连接、倒装连接各有特点。其中倒装连接以结构紧凑,可靠性高在封装行业应用越来越广泛。
二、什么是倒装芯片技术?
伴随半导体芯片体积的逐渐减小,对芯片封装技术要求越来越高,封装技术向着晶圆及封装发展。

在对传统芯片进行封装时,通常是将晶圆进行切割成Die,再对每一个Die进行封装,伴随封装技术的成熟,在最新的半导体封装中,将封装工艺与半导体工艺进行融合,在晶圆上对芯片进行统一封装,再切割形成可靠性更高的独立芯片。
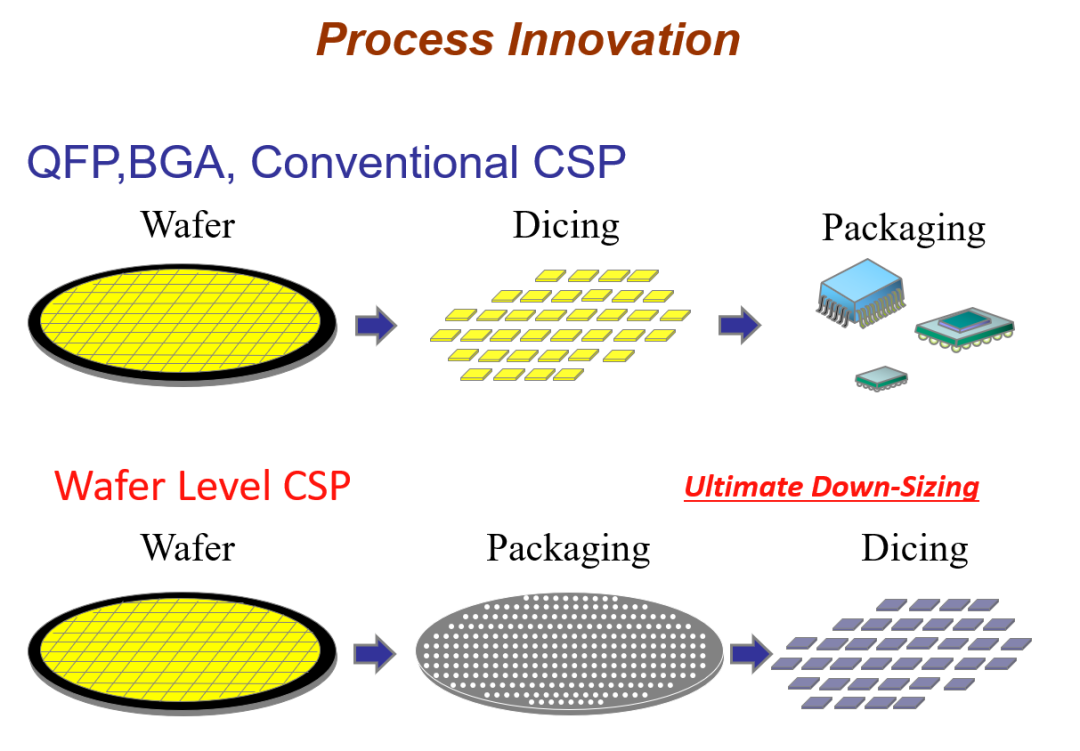
随着倒装技术的成熟应用,目前全世界的倒装芯片消耗量超过年60万片,且以约50%的速度增长,3%的晶圆封装用于倒装芯片凸点技术,几年后可望超过20%。
倒装芯片元件主要用于半导体设备,有些元件,如无源滤波器,探测天线,存储器装备也开始使用倒装芯片技术,由于芯片直接通过凸点直接连接基板和载体上。因此,更确切的说,倒装芯片也叫DCA(Direct Chip Attach),下图中CPU及内存条等电子产品是最常见的应用倒装芯片技术的器件。
下图是内存条中存储芯片通过倒装技术与线路板连接,芯片与电路板中间通过填充胶固定。
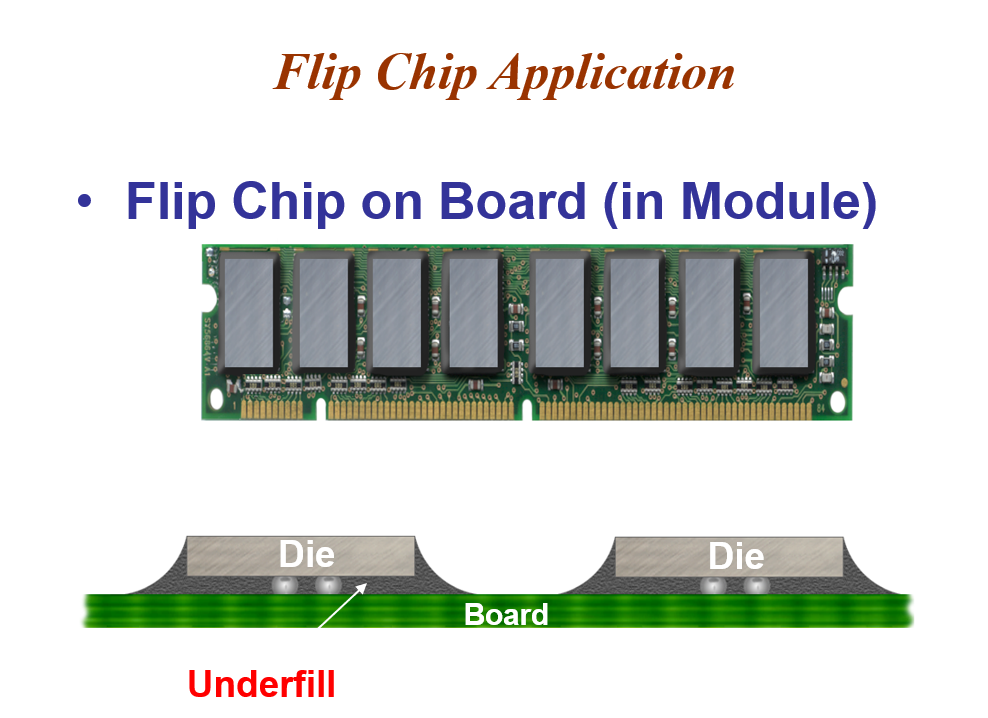
在典型的倒装芯片封装中, 芯片通过3到5个密耳(1mil=25um)厚的焊料凸点连接到芯片载体上,底部填充材料用来保护焊料凸点。
下图是一张典型的倒装连接图,芯片与下方的基板采用倒装方式连接:
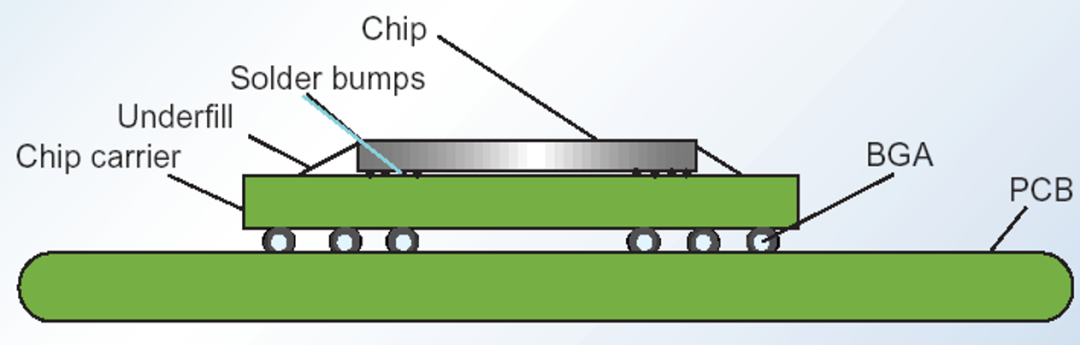
三、倒装技术技术细节


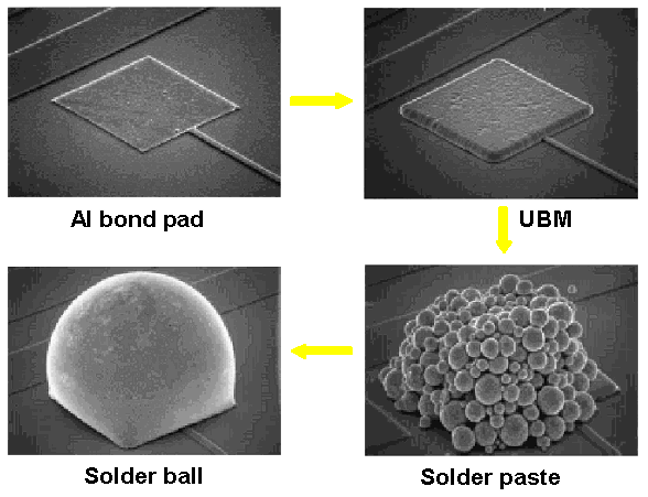
其中电镀焊料凸点的具体形成过程如下图:
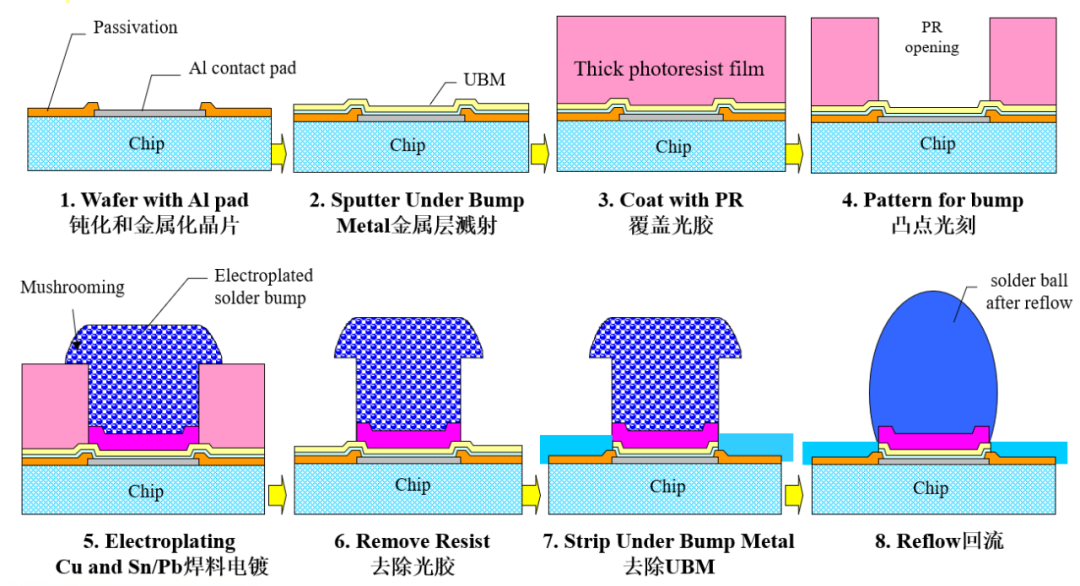

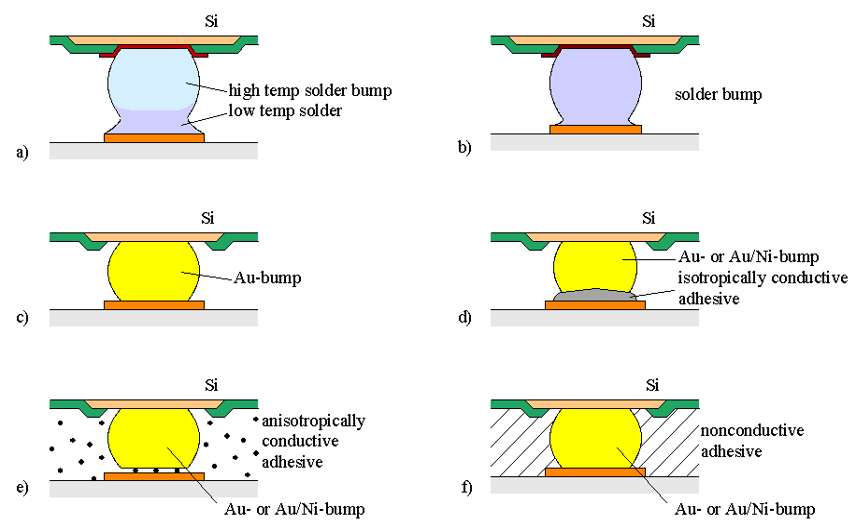
芯片表面形成的凸点在扫描电镜下观察到的外观如下图所示:
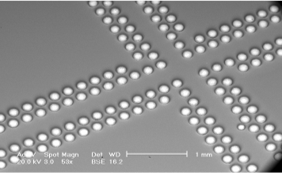
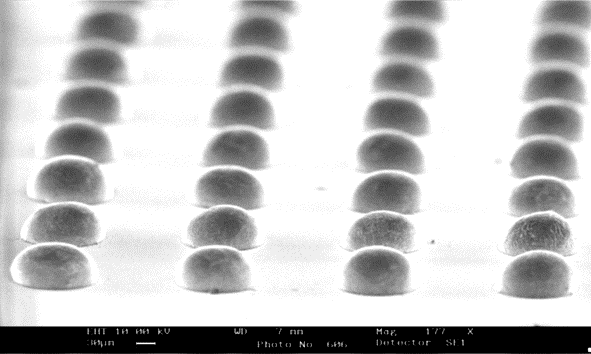
下图中的左图是回流(高温)前的凸点状态,右图是经高温后的凸点状态,经高温后凸点融化成球形。
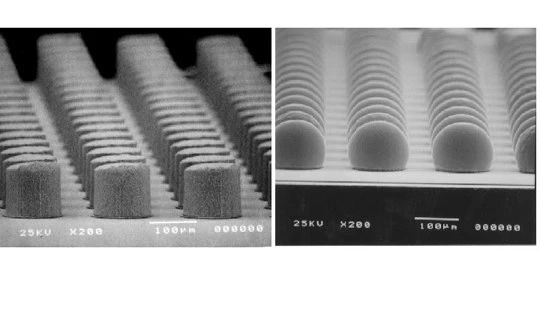
化学镀UBM和丝网印刷工艺(Electroless UBM and Stencil Printing)是工业应用中低成本倒装焊凸点制备方法。
以下是丝网印刷凸点制作流程(Stencil Printing Process Flow)及完成后的凸点形貌:
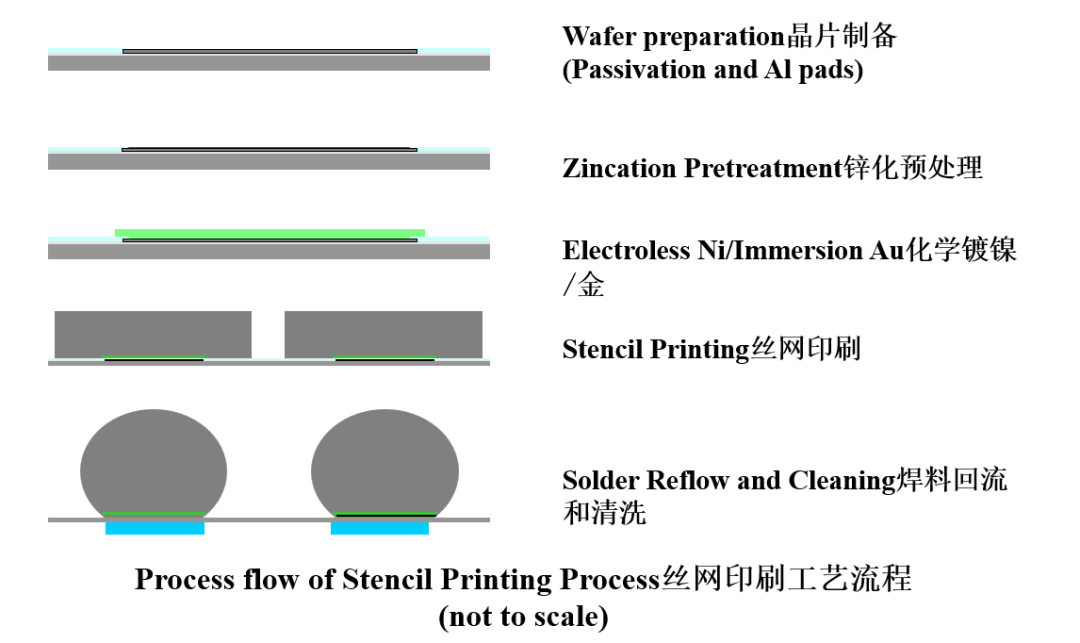


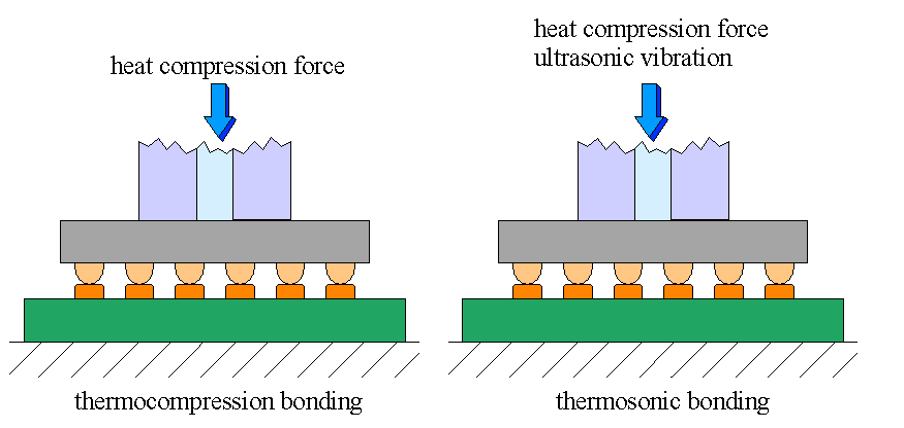
第四步:底部填充与固化
倒装连接后已完成了芯片与基板的连接,为了提高倒装稳定性,会在倒装后的芯片与基板之间采用填充胶加固,填胶工艺如下图所示:
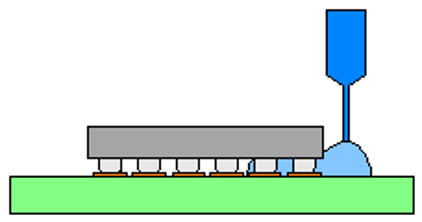


(c)性能增加: 短的互连距离减小了电感、电阻以及电容,保证了信号延迟减少、较好的高频率、以及从晶片背面较好的热通道。
(d)提高了可靠性:大芯片的环氧填充确保了高可靠性。倒装芯片可减少三分之二的互连引脚数。

审核编辑:刘清