时间:2023-10-09 17:40
人气:
作者:admin
No.1 案例背景
某QFP器件发生不良,不良率约10%,初步判断为接地焊点可能存在虚焊现象。
No.2分析过程
Analysis process
Part.1
X-Ray观察
0°观察
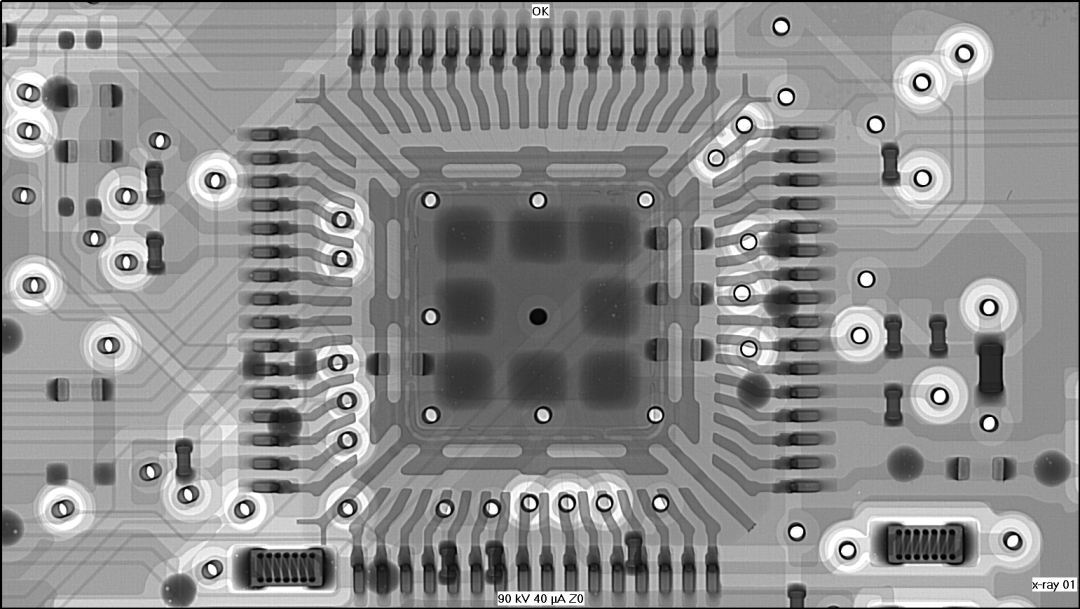
倾斜45°观察
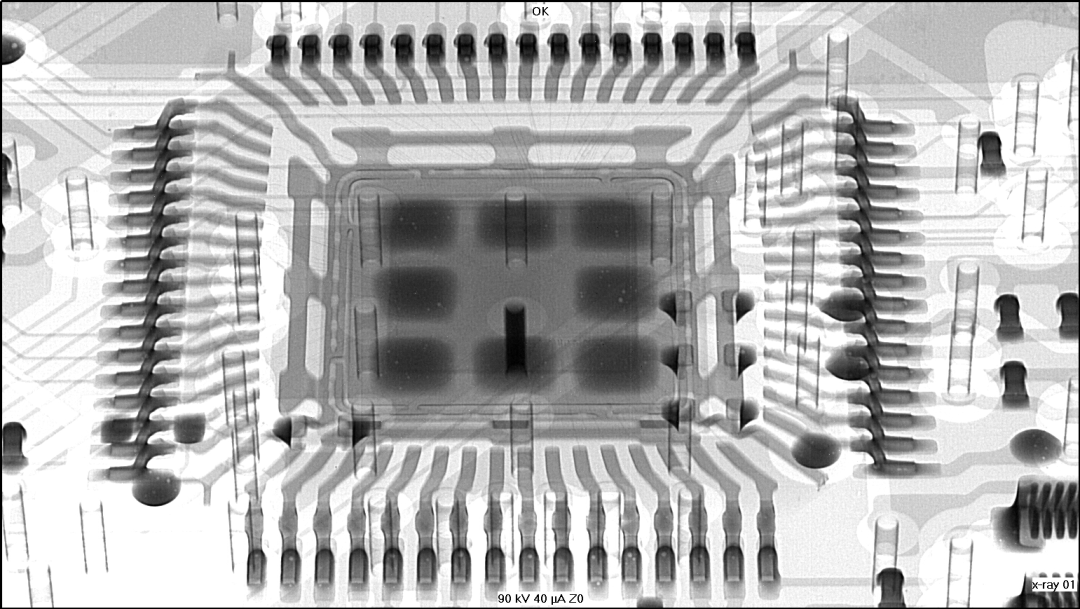
说明
对样品进行X-ray检测,接地部分呈现明显的阴影雾状,可能存在虚焊问题。
Part.2
接地焊盘切片断面分析
接地焊点切片分析图



说明
通过切片断面分析,部品的一侧焊点有明显虚焊,焊锡与器件镀层未互熔,虚焊点两侧有明显锡填充不足的现象。
切片断面测量

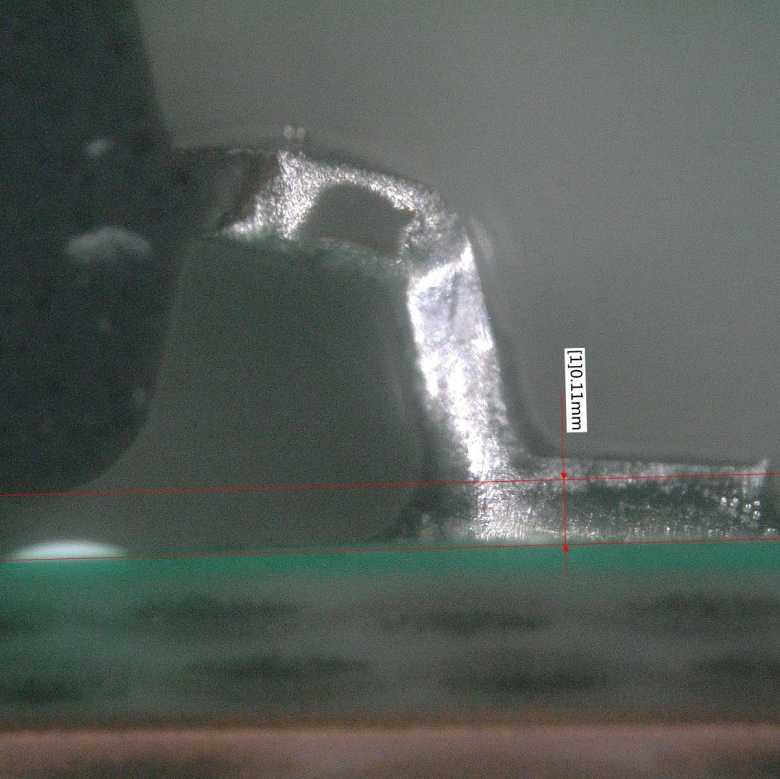
说明
部品底部焊盘到PCB侧焊盘距离为0.11㎜,部品底部到引脚底部的距离为0.11㎜。
Part.3
SEM形貌分析
端子侧焊点未融合SEM图示
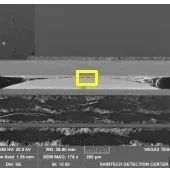

说明
器件镀层和焊锡之间存在约5μm的缝隙,界面状态显示二者有作用过,但未互熔,形成了自然状态的冷却形貌。
PCB侧的IMC状态分析SEM图示
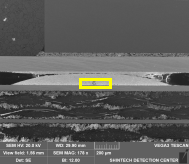
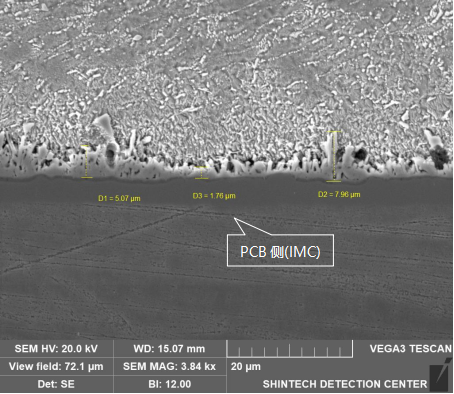
说明
图示位置PCB侧焊锡IMC层状态,整体连续、致密,平均厚度约在3μm左右。
Part.4
EDS成分分析
焊锡未融合处成分
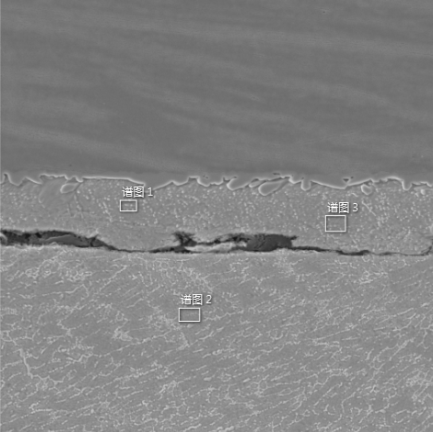

说明
EDS分析结果,镀层面主要有Sn、Cu元素,未检出异常成分。
PCB侧IMC成分


说明
PCB侧为IMC层Ni(18.52)、Sn(76.39%)、Cu(5.09%),无异常元素。
器件接地焊盘镀层成分


说明
从接地焊盘镀层的分析判断,器件接地镀层为Sn(纯锡)。
Part.5
其他因素对焊锡的影响
器件尺寸
影响接地焊接的关键尺寸:A1 Standoff,器件接地焊盘到端子底部的距离。



说明
上述A1尺寸的测量结果显示,A1尺寸均接近0.1mm。发生虚焊产品使用的钢网厚度为0.11mm
A1尺寸的影响:
在开口面积稍大的情况下,锡膏印刷的厚度一般会≤0.11mm,回流后由于锡膏体积变小,会发生塌陷。
若A1尺寸偏大,则存在锡膏和接地焊盘不能充分接触的风险。
回流温度

说明
失效样对象品生产时采用的替代测温标本,且器件接地部分未监控温度,后续制作对应测温标本,针对接地点的温度实际测试如上图所示。最高温度246.5℃,220℃以上时间60s,232℃以上时间40.5s。从焊接温度的适合性上判断,即使器件镀层为纯锡,该温度也不会引起虚焊问题(液相时间充足)。
No.3分析结果
Analysis results
失效原因分析
综合上述检测结果,对接地虚焊的失效原因分析如下:
1.失效特征:焊锡与器件接地焊盘镀层虚焊,二者未互熔,虚焊点两侧有明显锡填充不足的现象。但从形貌分析,二者在回流过程中有相互接触作用,形成了凹凸状,如下图:

2.对器件关键尺寸和回流温度的分析,器件A1尺寸接近0.1mm,使用的钢网厚度0.11mm,存在锡膏与器件接地部分接触不充分的隐患。
基于以上测试及分析判断,导致器件接地焊盘虚焊的原因为在器件Standoff A1尺寸偏大的情况下,钢网接地部分的厚度为0.11mm,由于回流后锡膏体积减小,形成的焊点高度可能小于0.1mm,从而使焊锡与器件接地焊盘接触不充分,形成虚焊。
分析验证
增加QFP接地部分的印锡厚度(使用部分阶梯钢网,0.11→0.15阶梯),进行实际的生产验证,接地部分虚焊的问题未再发生,从而证明了器件Standoff尺寸与钢网厚度匹配性关系存在隐患。
案例启示
针对QFP封装器件,在钢网设计时,要关注器件Standoff尺寸,确定其允差范围,从钢网厚度(接地局部)上做好预防性规避措施,避免因为器件Standoff允差造成的潜在性焊接失效。
审核编辑:刘清