时间:2023-07-07 14:55
人气:
作者:admin
上海伯东美国 KRi 考夫曼离子源 KDC 40 应用于双腔室高真空等离子 ALD 系统, 实现小规模试验中 2-4 英寸硅片等半导体衬底表面的清洁, 确保样品表面清洁无污染, 满足 TiN, ZnO, Al2O3, TiO2 等制备.

KRi 考夫曼离子源 KDC 40 预清洁可以实现
去除物理吸附污染: 去除表面污染, 如水, 吸附气体, 碳氢化合物残留
去除化学吸附污染: 去除天然和粘合材料. 如表面氧化物, 通常去除 < 100Å
提高沉积薄膜附着力, 纯度, 应力, 工艺效率等.
数据来源: 美国 KRi 原厂资料
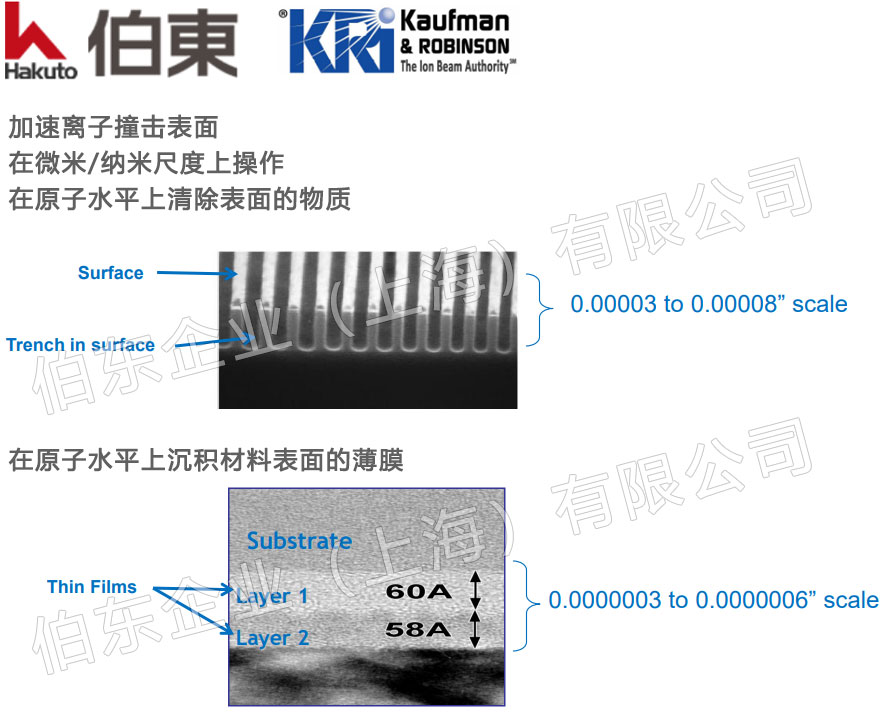
KRi 考夫曼离子源KDC 40 技术参数
上海伯东美国 KRi 小型低成本直流栅极离子源 KDC 40 是 3cm 考夫曼型离子源升级款. 具有更大的栅极, 更坚固, 可以配置自对准第三层栅极. 通过加热灯丝产生电子, 是典型的考夫曼型离子源, 提供低浓度高能量宽束型离子束.
KDC 40 适用于所有的离子工艺, 例如预清洗, 表面改性, 辅助镀膜, 溅射镀膜, 离子蚀刻和沉积.离子源KDC 40 兼容惰性或活性气体, 例如氧气和氮气. 标准配置下离子能量范围 65 至 1200ev, 离子电流可以超过 140 mA.

上海伯东同时提供真空系统所需的涡轮分子泵,真空规,高真空插板阀等产品, 协助客户生产研发高质量的真空系统.
1978 年 Dr. Kaufman 博士在美国创立 Kaufman & Robinson, Inc 公司, 研发生产考夫曼离子源,霍尔离子源和射频离子源. 美国考夫曼离子源历经40 年改良及发展已取得多项专利. 离子源广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域.
下一篇:霍尔开关在跳绳中如何应用