时间:2023-06-09 09:17
人气:
作者:admin
磨片时,需要在正面(Active Area)贴胶带保护电路区域 同时研磨背面。研磨之后,去除胶带,测量厚度;
BGA Package Structure

SIDE VIEW
Typical Assembly Process Flow
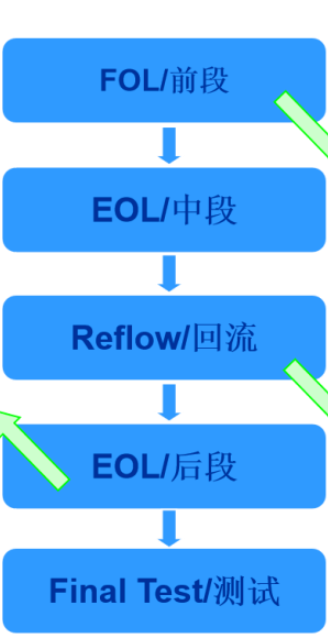
FOL– Front of Line前段工艺

FOL– Front of Line Wafer
【Wafer】晶圆

FOL– Back Grinding背面减薄


将从晶圆厂出来的Wafer进行背面研磨,来减薄晶圆达到 封装需要的厚度(5mils~10mils);
磨片时,需要在正面(Active Area)贴胶带保护电路区域 同时研磨背面。研磨之后,去除胶带,测量厚度;
FOL– Wafer Saw晶圆切割


目的:
将晶圆粘贴在蓝膜(Tape)上,使得即使被切割开后,不会散落;
通过Saw Blade将整片Wafer切割成一个个独立的Dice,方便后面的 Die Attach等工序;
Wafer Wash主要清洗Saw时候产生的各种粉尘,清洁Wafer;
FOL– Back Grinding背面减薄

FOL– Wafer Saw晶圆切割

FOL– Optical Inspection

主要是针对Wafer Saw之后在显微镜下进行Wafer的外观检查,是否有出现不良产品。

Chipping Die 崩 边
FOL– Die Attach 芯片粘接


FOL– Die Attach 芯片粘接

芯片拾取过程:
1、Ejector Pin从wafer下方的Mylar顶起芯片,使之便于脱离蓝膜;
2、Collect/Pick up head从上方吸起芯片,完成从Wafer到L/F的运输过程;
3、Collect以一定的力将芯片Bond在点有银浆的L/F的Pad上,具体位置可控;
4、Bond Head Resolution:X-0.2um;Y-0.5um;Z-1.25um;
5、Bond Head Speed:1.3m/s;
FOL– Die Attach 芯片粘接

FOL– Epoxy Cure 银浆固化,检验
FOL– Wire Bonding 引线焊接

利用高纯度的金线(Au) 、铜线(Cu)或铝线(Al)把 Pad 和 Lead通过焊接的方法连接起来。Pad是芯片上电路的外接 点,Lead是 Lead Frame上的 连接点。
W/B是封装工艺中最为关键的一部工艺。
FOL– Wire Bonding 引线焊接
【Gold Wire】焊接金线

实现芯片和外部引线框架的电性和物理连接;
金线采用的是99.99%的高纯度金;
同时,出于成本考虑,目前有采用铜线和铝线工艺的。铜铝线优点是成本降低,同时工艺难度加大,良率降低;
线径决定可传导的电流;0.8mil,1.0mil,1.3mils,1.5mils和2.0mils;
FOL– Wire Bonding 引线焊接
Key Words:
Capillary:陶瓷劈刀。W/B工艺中最核心的一个Bonding Tool,内部为空心,中间穿上金线,并分别在芯片的Pad和Lead Frame的Lead上形成第一和第二焊点;
EFO:打火杆。用于在形成第一焊点时的烧球。打火杆打火形成高温,将外露于Capillary前端的金线高温熔化成球形,以便在Pad上形成第一焊点(Bond Ball);
Bond Ball:第一焊点。指金线在Cap的作用下,在Pad上形成的焊接点,一般为一个球形;
Wedge:第二焊点。指金线在Cap的作用下,在Lead Frame上形成的焊接点,一般为月牙形(或者鱼尾形);
W/B四要素:压力(Force)、超声(USG Power)、时间(Time)、温度(Temperature);
FOL– Wire Bonding 引线焊接


FOL– Wire Bonding 引线焊接

FOL– Wire Bonding 引线焊接


FOL–Optical Inspection 检查
检查Die Attach和Wire Bond之后有无各种废品
正常品






Material Problem






1st Bond Fail ( I )
Peeling


1st Bond Fail (II)
Ball Lift

1st Bond Fail ( III )
Neck Crack

1st Bond Fail (IV)
Off Center Ball

1st Bond Fail (V)
Smash Ball

Bonding Weld Inspection
Weld Detection

2nd Bond Fail ( II )

Looping Fail(Wire Short I)

Looping Fail(Wire Short II)
Loop Base Bend

Looping Fail(Wire Short III)
Excessive Loop


EOL– End of Line后段工艺

EOL– Molding(注塑)
【Mold Compound】塑封料/环氧树脂
主要成分为:环氧树脂及各种添加剂(固化剂,改性剂,脱 模剂,染色剂,阻燃剂等);
主要功能为:在熔融状态下将Die和金丝等包裹起来,提供物理和电气保护,防止外界干扰;
存放条件:零下5°保存,常温下需回温24小时;

EOL– Molding(注塑)
为了防止外部环境的冲击,利用EMC把Wire Bonding完成后的产品封装起来的过程,并需要加热硬化。

EOL– Molding(注塑)

EMC(塑封料)为黑色/白色块状,低温存储,使用前需先回温。其特性为:在高温下先处于熔融状态,然后会逐渐硬化,最终成型。
Molding参数:
Molding Temp:175~185°C;
Clamp Pressure:3000~4000N;
Transfer Pressure:1000~1500Psi;
Transfer Time:5~15s;Cure Time:60~120s;
EOL– Molding(注塑)
下压式注塑

EOL– Molding(注塑)
常見之Molding 缺陷
充填不良 ( Incomplete Fill )
黏膜 ( Sticking )
氣孔 ( Void/Blister )
金線歪斜 ( Wire Sweep )
晶片座偏移 ( Pad Shift )
表面針孔 ( Rough Surface in Pin Hole)
流痕 ( Flow Mark )
溢膠 ( Resin Bleed )
EOL– Post Mold Cure(模后固化)


用于Molding后塑封料的固化,保护产品内部结构,消除内部应力。
Cure Temp:175+/-5°C;Cure Time:4—8Hrs
EOL– Laser Mark(激光打字)


EOL– Ball Attach 植球

EOL– Ball Attach 植球





EOL– Singulation
將整條CLAER 完畢之SUBSTRATE產品,切割成單顆的正式 BGA 產品


EOL– Test 测试
根据测试程式检测产品的功能、元器件的连接情况等

EOL– Final Visual Inspection(终检)

Final Visual Inspection-FVI
在低倍放大镜下,对产品外观进行检查。主要针对EOL工艺可能产生的废品:例如Molding缺陷,切单缺陷和植球缺陷等;
EOL– Packing 包装
按照一定的批次数量等 装箱出货

编辑:黄飞
下一篇:芯片制造之光刻工艺详细流程图