时间:2023-09-22 15:08
人气:
作者:admin
对于球间距小到0.1 mm的元件,需要怎样的贴装才能达到较高的良率?基板的翘曲变形、阻焊膜窗口的尺寸和位置偏差,以及机器的等都会影响到终的贴装。关于基板设计和制造的情况对于贴装的影响,这里我们只讨论机器的贴装。
为了回答上面的问题,我们来建立一个简单的假设模型:
①假设倒装晶片的焊凸为球形,基板上对应的焊盘为圆形,且具有相同的直径;
②假设无基板翘曲变形及制造缺陷方面的影响:
③不考虑Theta和冲击的影响;
④在回流焊接过程中,元件具有自对中性,焊球与润湿面50%的接触在焊接过程中可以被“拉正”。
那么,基于以上的假设,直径25μm的焊球如果其对应的圆形焊盘的直径为25μm时,左右位置偏差(X轴)或前后位置偏差(Y轴)在焊盘尺寸的50%,焊球都始终在焊盘上(如图1所示)。
对于焊球直径为25μm的倒装晶片,工艺能力Cpk要达到1.33的话,要求机器的必须达到9μm@3sigma。
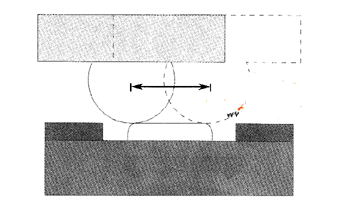
图1 焊球在焊盘上的位置偏差
下一篇:倒装晶片的组装工艺流程