时间:2023-08-02 15:17
人气:
作者:admin
覆晶载板的制造
1.覆晶载板FC Carrier是一种HDI增层(Build up)式多层板。其中Core板为高Tg(220℃)刚性强与超薄铜皮(5μm)的特殊板材。而增层者则一律为ABF/GX-13的干膜式板材,增层的各种铜导体则为SAP半加成法线路,目前可量产的线宽线距为15μm/15μm。
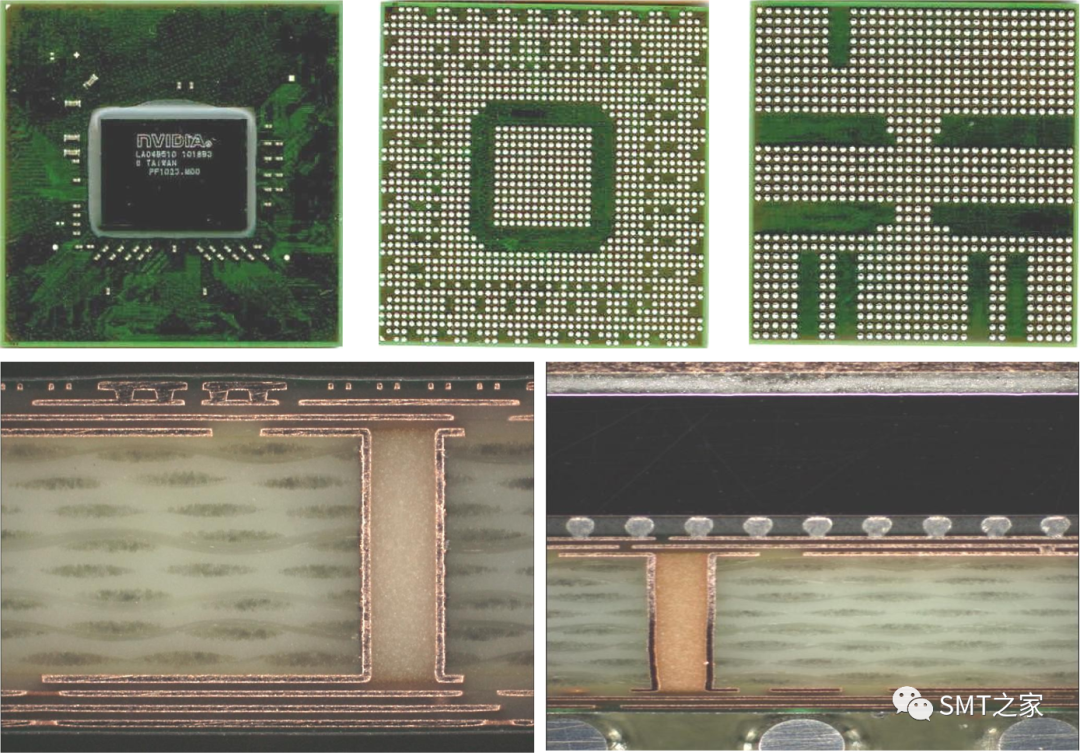
1.1.2 半加成SAP法(Semi-Additive Process)是利用大运味之素(Ajinomotor)之白色干膜式薄卷材 为增层的介质(Dielectrics)材料,再利用化学钯与化学铜做为电镀铜增厚的基地,并按现行减成法制做细线与重复互连工程而成为覆晶载板。
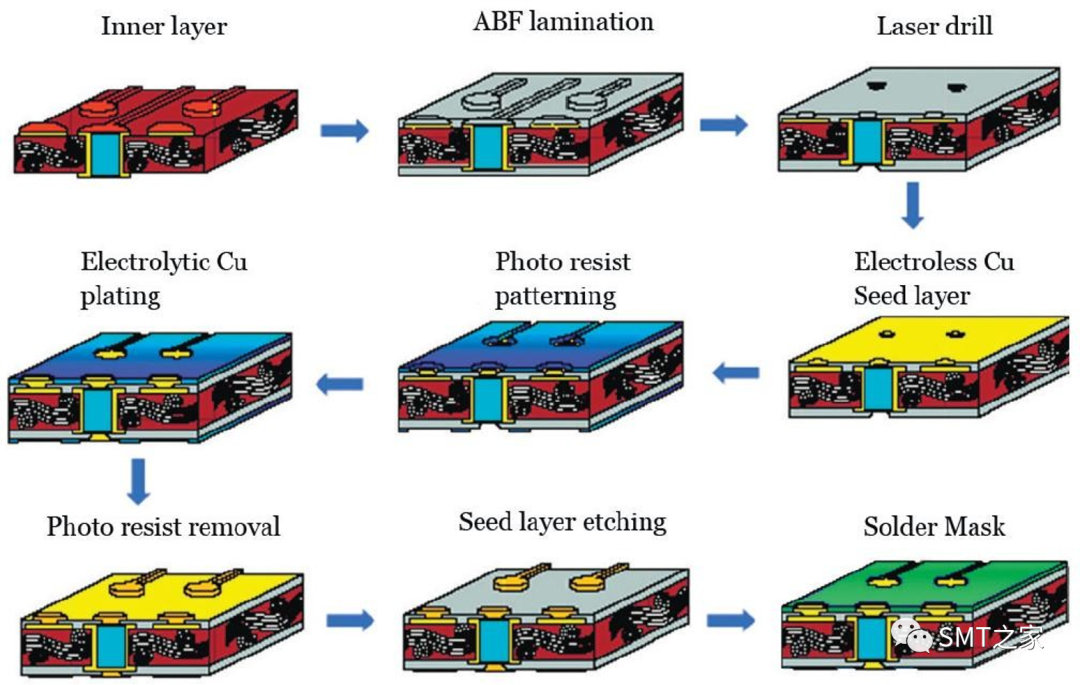
1.1.3 半加成法是利用正统PTH流程之化学钯与化学铜做为导电基地,而进一步在光阻定义下以电镀铜增厚完成二次铜的线路,去光阻与差别性蚀刻(Differential Etching)后即可取得互连的细线与盲孔,但咬不掉的贵金属残钯层却成为绝缘不良的隐忧。
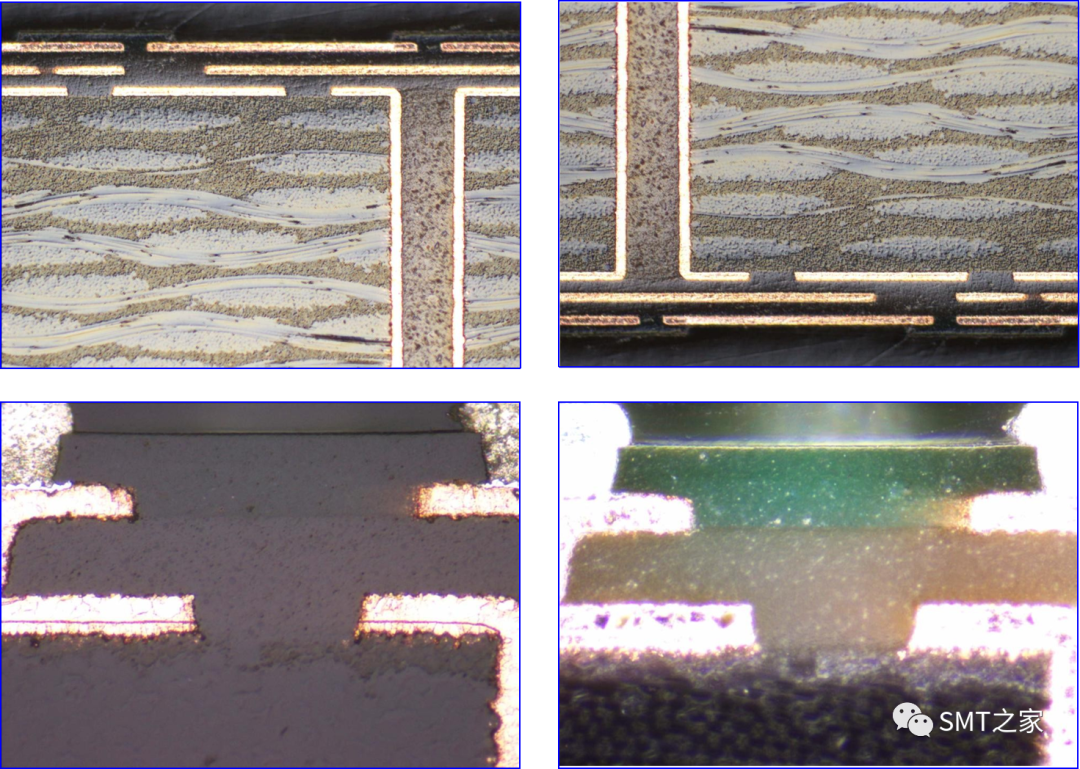
1.1.4 目前最常用白色的ABF/GX-13中含SiO2球形填充料Fillers已较多,约30% w/w,厚度 40μm,宽度502㎜,每卷总长100m单价达NT四万元,排版510*600 mm者每片NT 250元。压合熟化后Tg达170℃。经Desmear将盲孔壁与全增面先行粗化,之后浸镀上化学钯与铜 的金属化后,即可代替传统铜箔用途而称为SAP法,但同时也留下残钯的隐忧。

1.1.5 覆晶载板经绿漆完工后还 需进行表面处理的可焊工程,也就是需在载板正面中央区绿漆开口(SRO)的凸块(Bump)铜 质承垫上,以及正面外围被动原件的贴焊与反面的植球垫上同时加镀化学锡。之后在凸块 垫上加印63/37的Low Alpha Eutectic锡膏并回焊与压平成为 FC的Presolder,其他两化锡区 则另外加印SAC 305的无铅锡膏与回焊,也都成为预銲料。
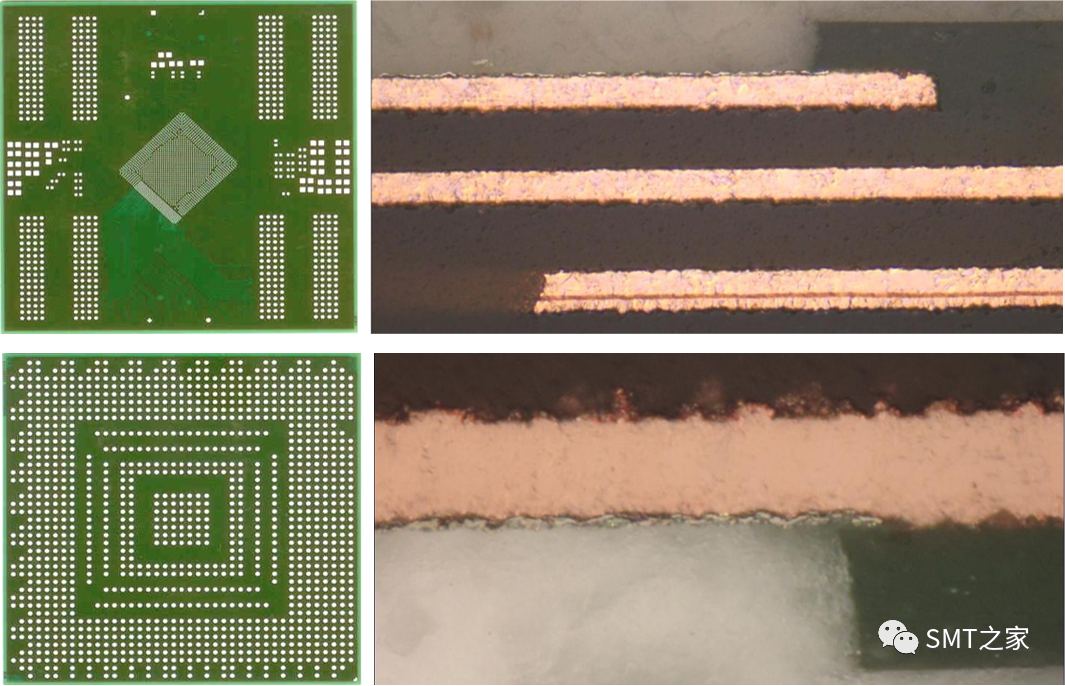
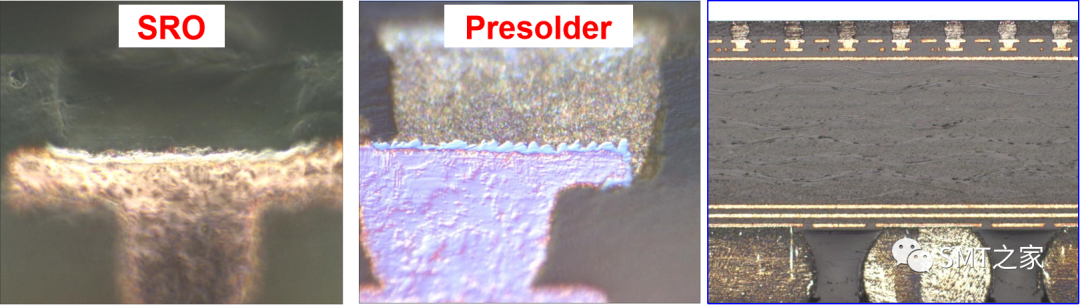
1.2 覆晶载板的封装
1.2.1 正统FC封装是以C4方式(Controlled Collapse Chip Connection)做为晶片UBM与载板上已有中铅预銲料( Presolder,Entectic 63/37 )之承垫间,另以高铅凸块Bump ( 95% pb + 5% Sn )为互连体进行三者的熔融互连(Inteconnection)。

1.2.2 正统C4高铅Bump的好处很多:(1)熔点高达320℃不受后段高温制程影响,(2)非常柔软,可降低外力的冲击(3)采助焊膏先黏着于预銲料上,后于230℃氮气回焊中不致发生空洞Void。但在环保压力也尽量在找无铅替代品,不过都存在着极多问题。
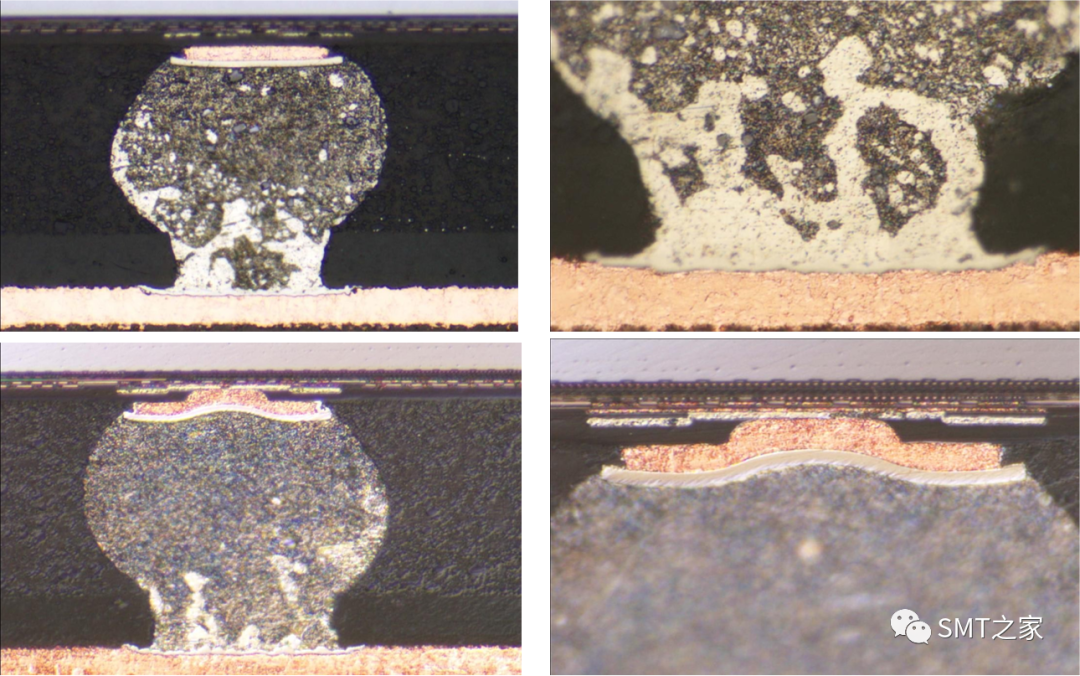

1.2.3 高铅式凸块封装的业者们为了RoHS的 禁铅与企业形象起见,都积极寻找高铅(95/5 或90/10)以外的替代品。已量产者多采63/37 Eutectic式中铅凸块为过渡性材料。
此种中铅銲料之柔软度尚好,但却因组成与 预銲料完全相同,致使助焊膏裂解的气体将大幅渗入凸块而形成空洞,且后续Bump间也容易出现熔锡短路的麻烦。
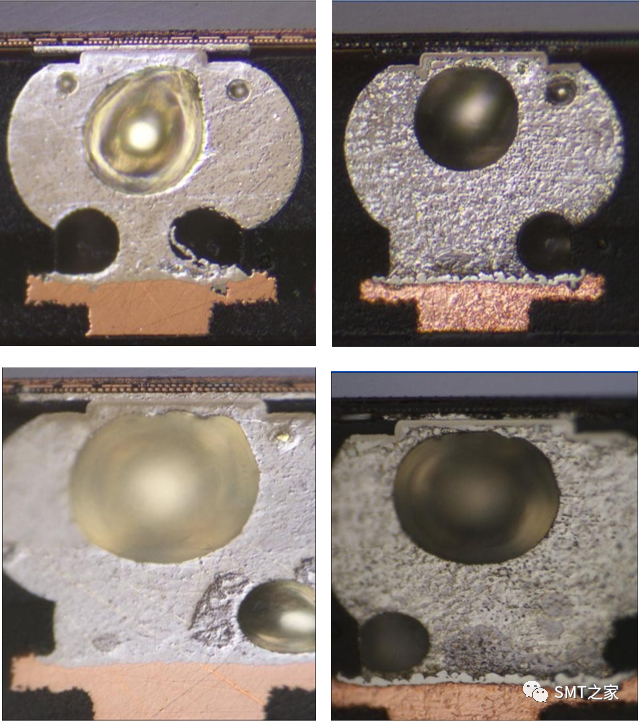
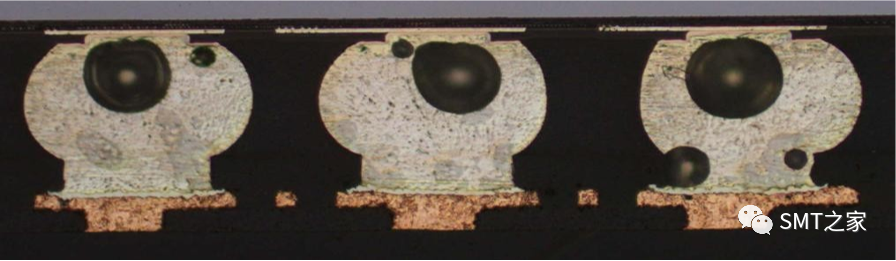
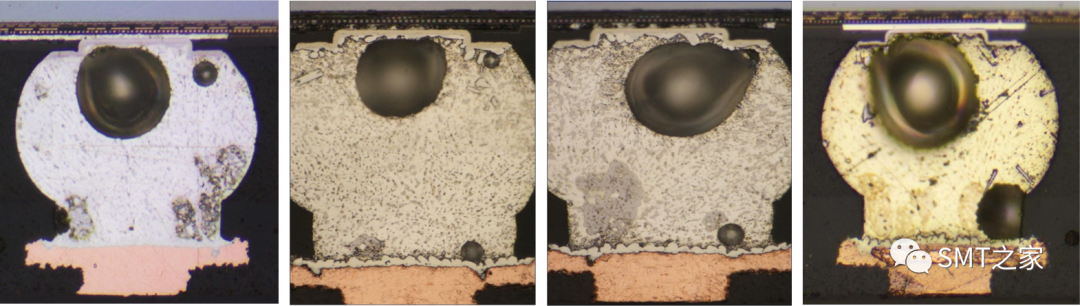
1.2.4 无铅凸块封装的试行量产
某些著名品牌的日商为了形象起见,乃率先采用无铅预銲料及无铅凸块进行FC封 装。须知SAC 305不但m.p.比63/37者高了34℃,而且弹性模量也多出25%(SAC 305为51GPa,63/37为40.2GPa)。由于305柔软性欠佳以及载板很薄刚性不足下,经覆晶、植球、以及PCBA等多次回焊强热中,难免造成角Bump或角Ball从僵硬銲料之IMC处被拉裂。此种必然性的失效或脆弱对可靠度将造成隐忧。
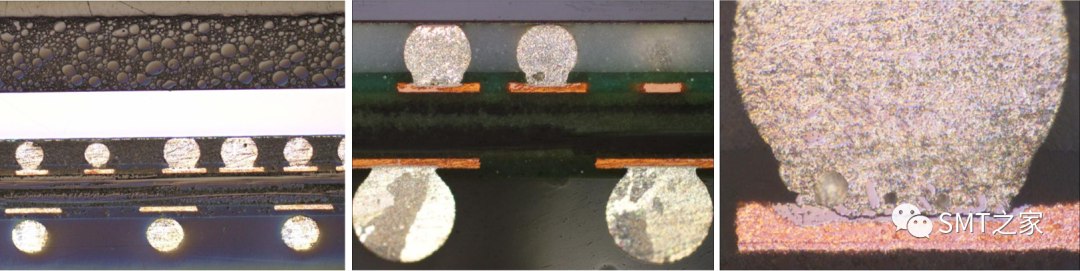
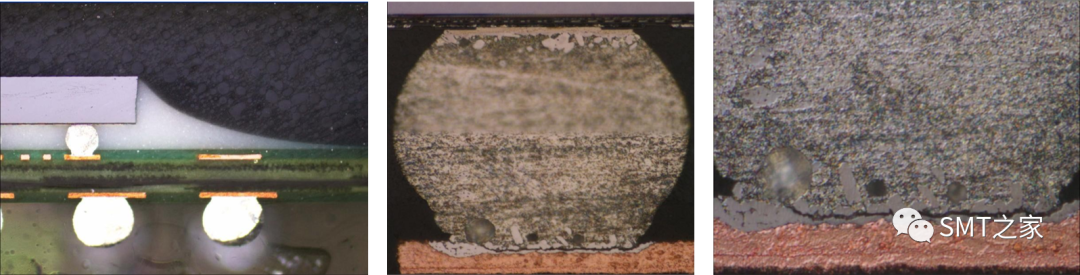
2.电路板整体性进展
逐层互连(ELIC)式HDI多层板类的兴起
现行镭射烧孔(Ablation) 每秒钟可达1,000孔,在成本大幅下降又加上镀铜填孔技术快速进步下,商品板500x600 mm 的双面百万盲孔者(载板有时可 达单面百万盲孔),均可轻松解 决。使得容易设计的ELIC式增层板也大为流行。

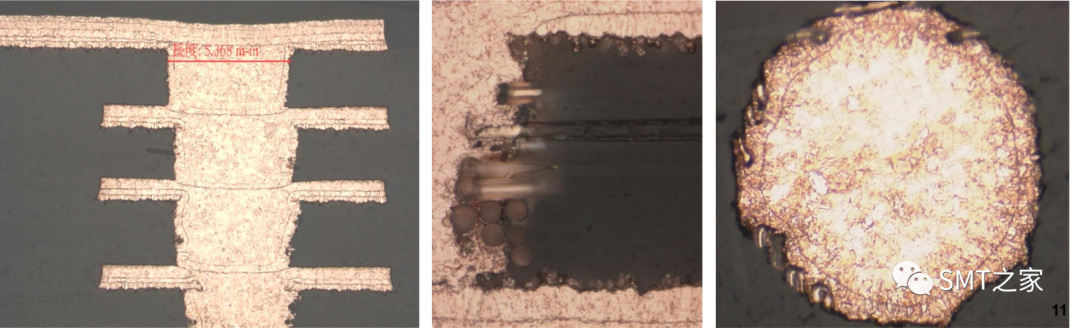
2.1.2 由于ELIC是经过多次压合,多次成像,多次填铜;且又是高精密度大排版的量产工 程,因而不但设备昂贵、流程漫长、工序严谨、导致变量极多。其制程管理与失效改善均亟需学理深入及经验丰富的高手进行解困,盲孔脱垫即为一例。
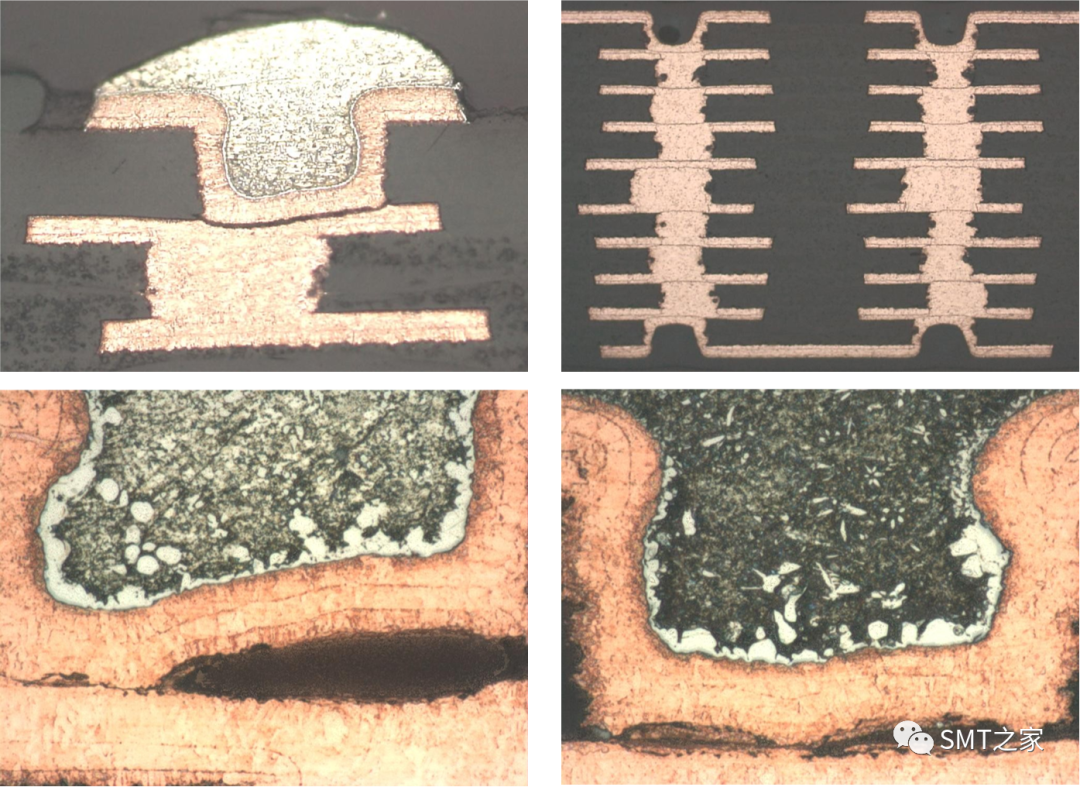
2.1.3 由于ELIC是多次重覆增层之精密制程,一旦稍有闪失,出货到客户端多次锡膏回焊中,难免会出现盲孔铜壁与底铜垫之间的界面分离。这种失效只要超过200 DPPM(以单片货板为统计单位)将立即成为严重客诉的案例。
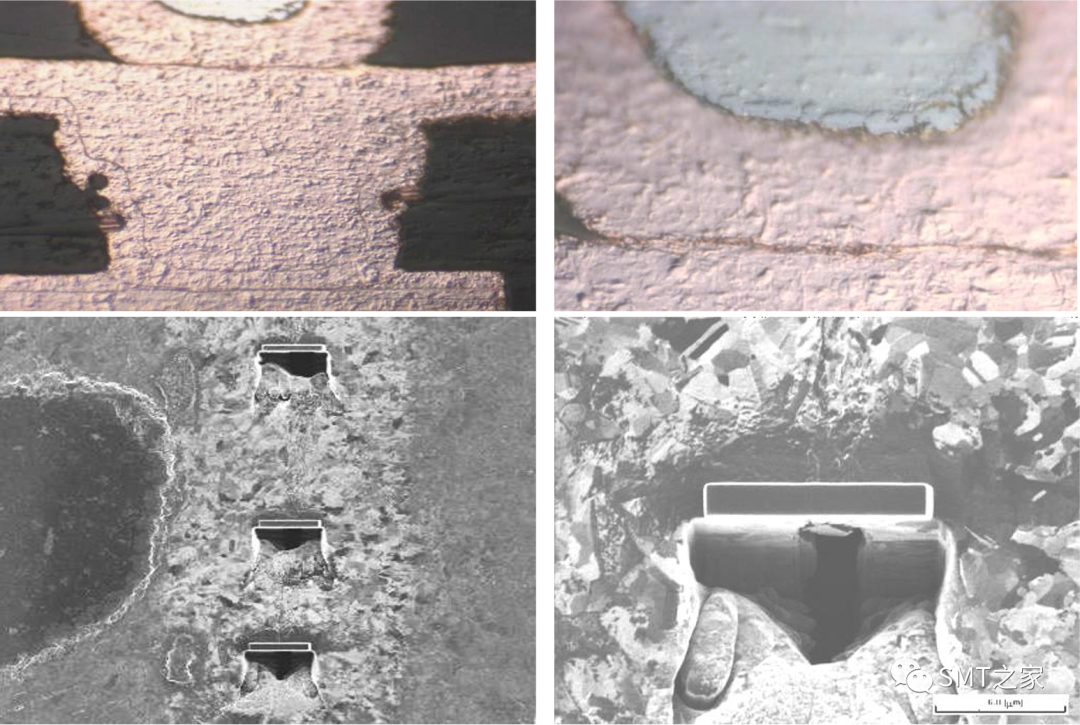
2.2 HDI商品板的困难化
2.2.1 以水果公司为代表的第四代手机板(HDI式10层之薄小板,厚度1㎜),其SMT组 装不但引入POP技术(下图左上)而且被动元件更已小到了01005(10㏕长,5㏕宽, 见下图右上),对PCB与PCBA均造成了另一次严酷的挑战。因为所贴焊的电容器太小,锡膏回焊中很容易发生立碑(Tomb Stoning)现象。
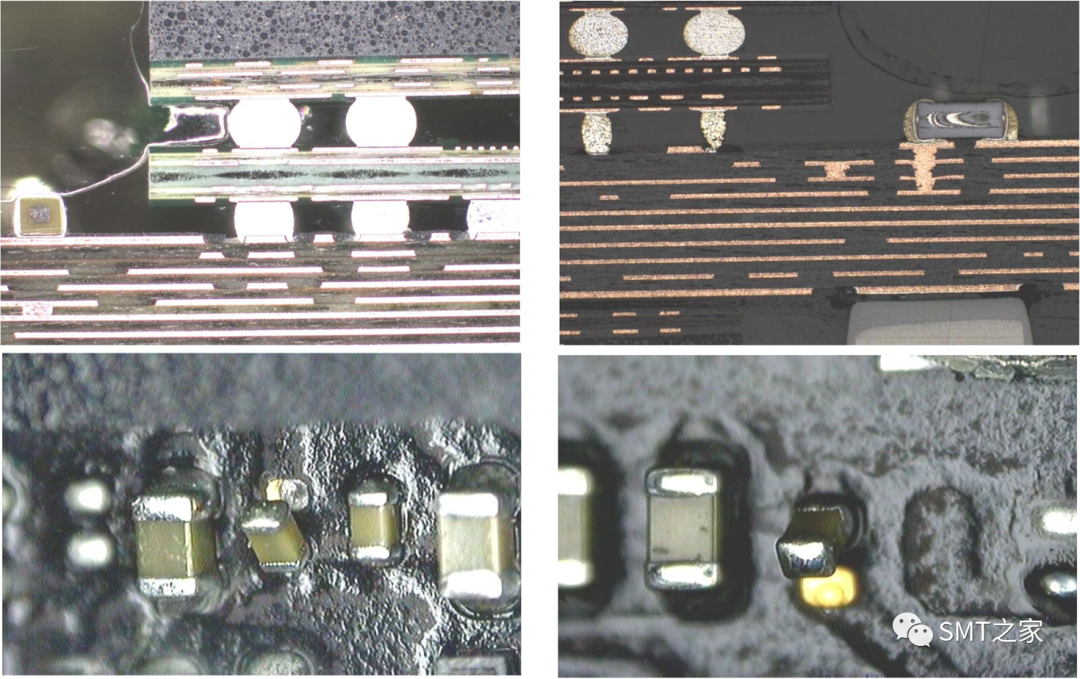
2.2.2 再从01005立碑处銲点之观察,可见到右封头之ENIG承垫几乎完全未出现Ni3Sn4小草般的IMC,証明焊接之初即已被左端较大的沾锡力量(Wetting Force)所拉起来了。
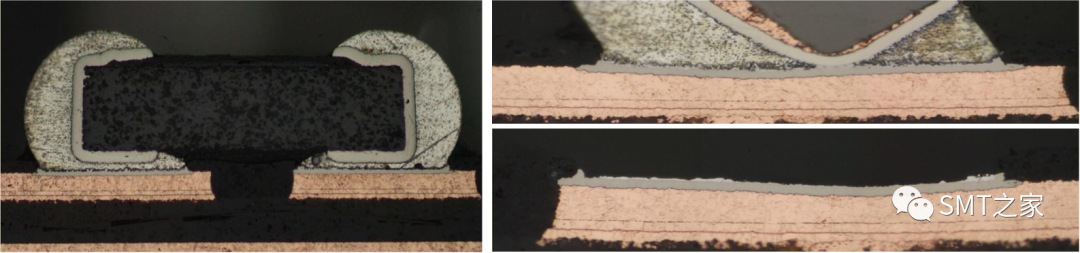
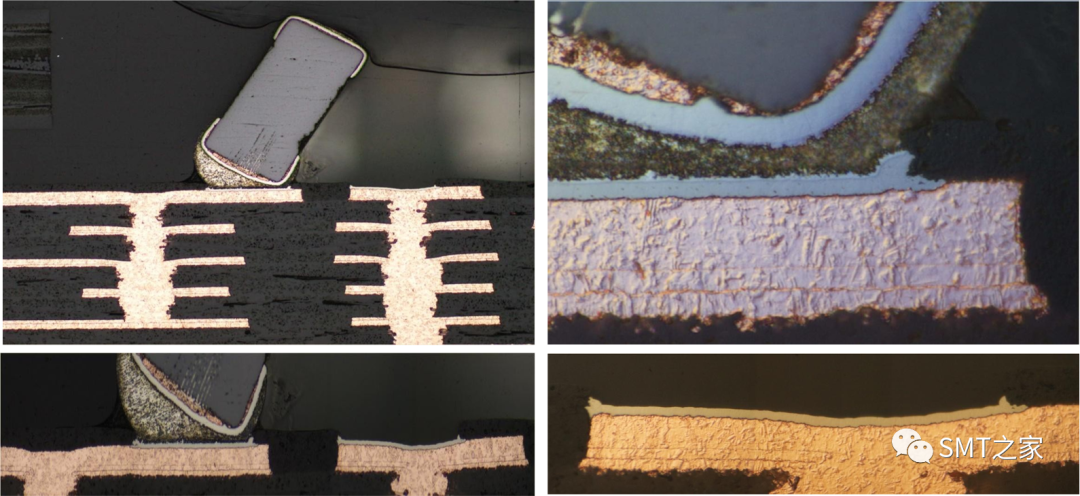
2.2.3 立碑的原因约可分为:两端头所受热量不均,绿漆过厚形成翘翘板效应,板材太软刚性不足,锡膏面上贴件时一端若踩歪,其回焊中将容易翘起而立碑。
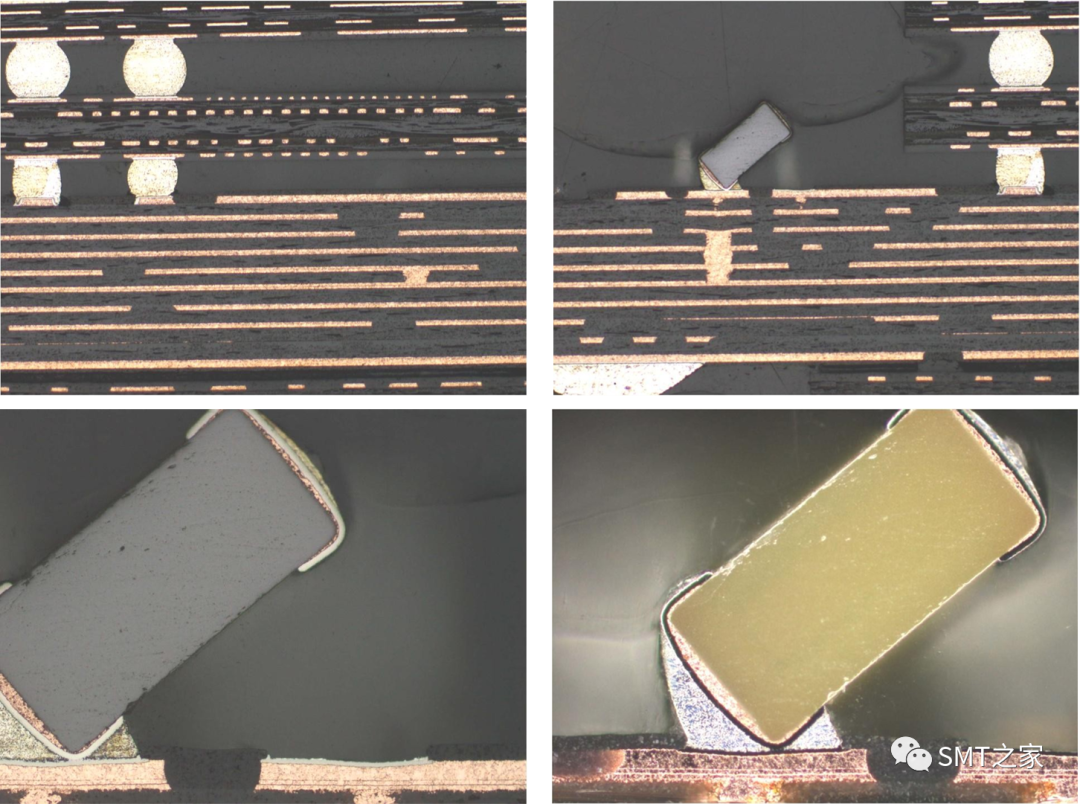
2.3 高可靠度级板类的兴起
2.3.1 板体厚大布局面单的汽车板,但却被要求Class Ш ( IPC-6012C/2010.4 )高可靠 度High Reliability的品级,当然其单价之高出也远超过小孔细线的商品板类。其中 AirBag,ABS等与安全有关的多层板类,其进入门槛更是高不可攀。
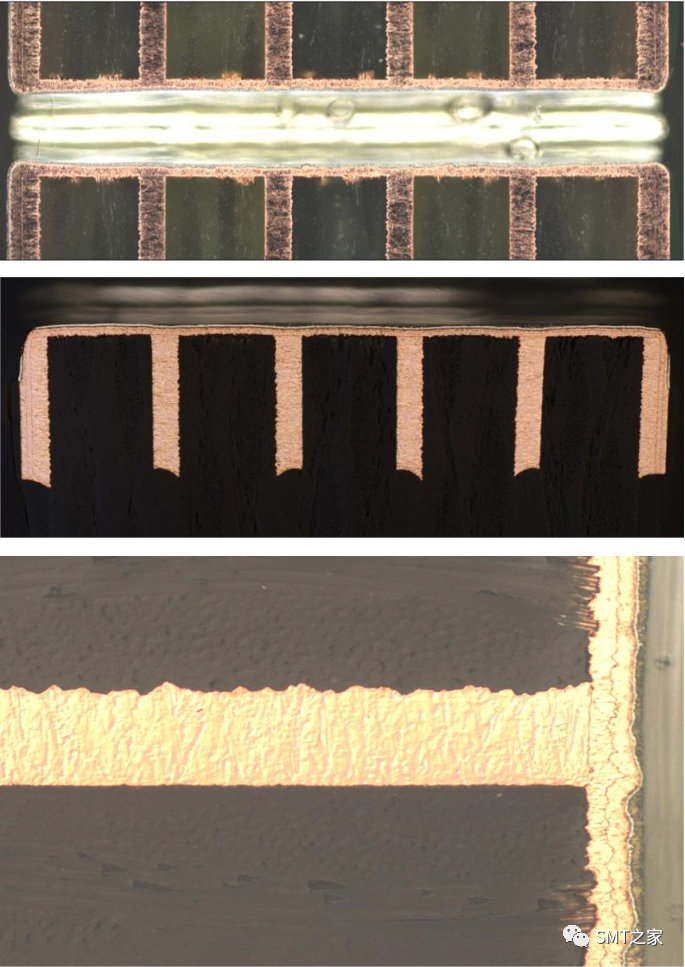
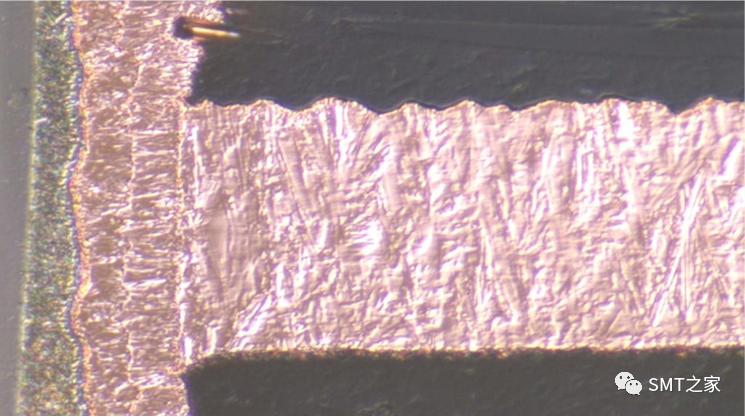
注意其等互连度毫无钉头Nail-Head与1mil以内渗铜wickin的高规格品质
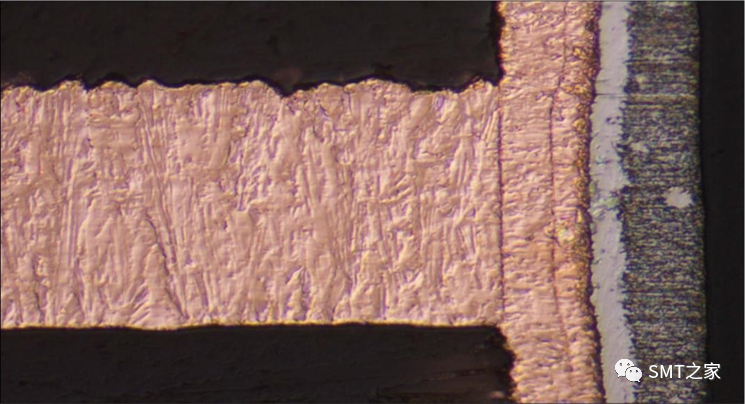
2.3.2例如布局简单叠构容易线路宽松的四层板,其内层两个铜面的厚度居然到达400um (16mil or 12oz)之罕见实例,成为PCB制程的一大挑战。


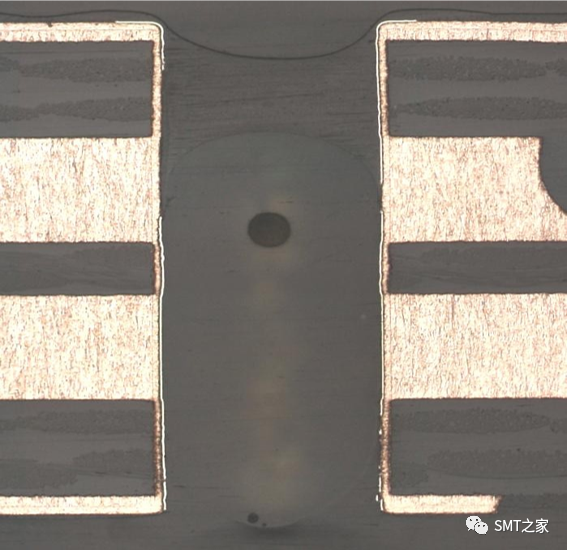

2.3.3 ClassШ的高级板,若与一般ClassⅡ工业级等数量庞大单价不高的资通板类相比较时,其质量之落差简直就是霄壤云泥。后者只要堪用根本谈不到可靠度。
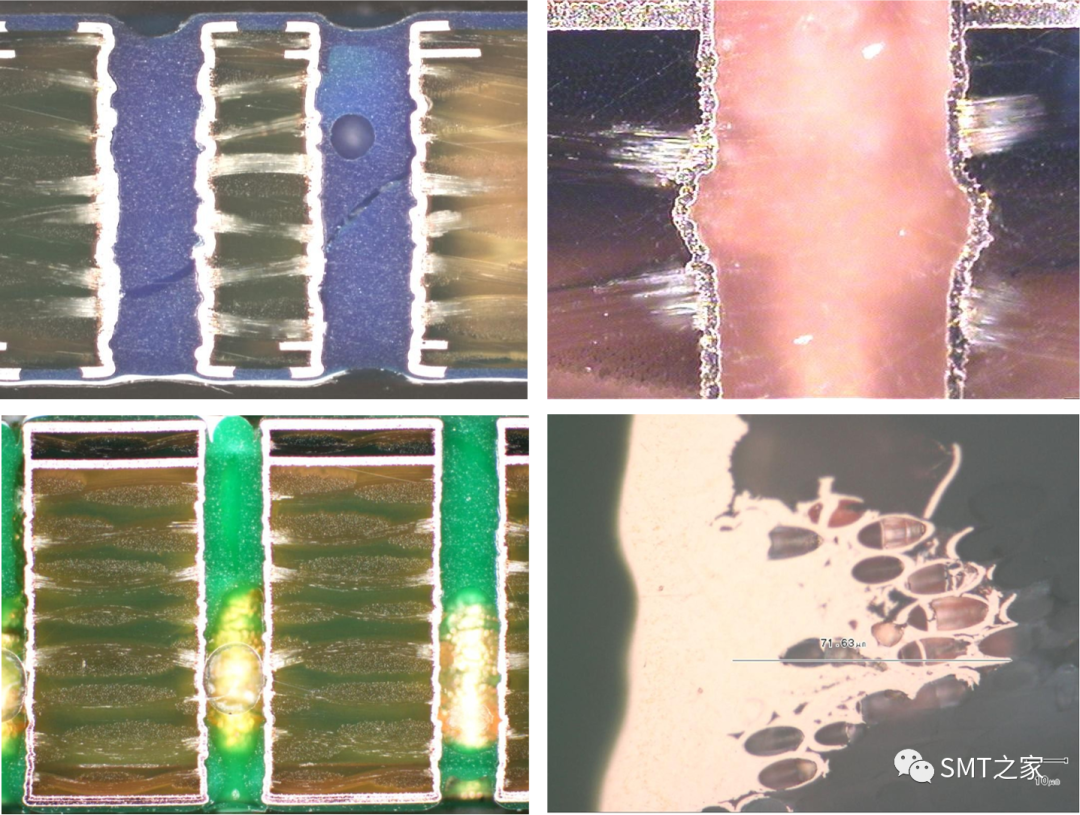
至于一般小厂或代工厂所生产之ClassⅠ消费级板类,在恶性竞争单价太低下,其板 材与制程品质也就无法提升了。

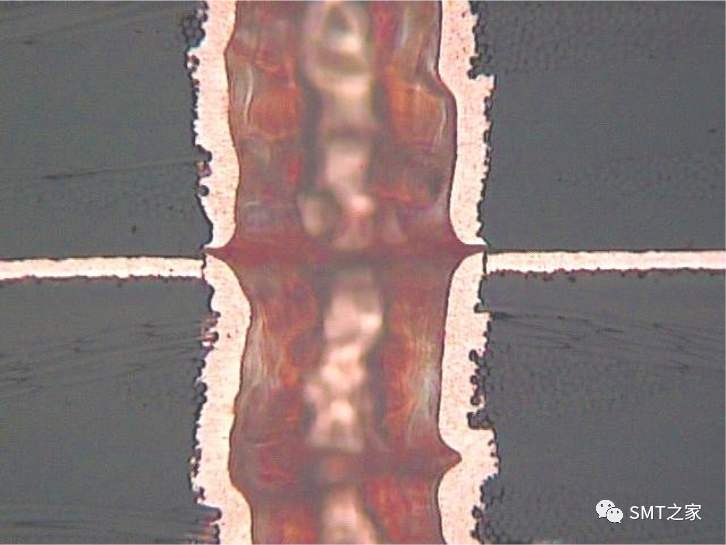
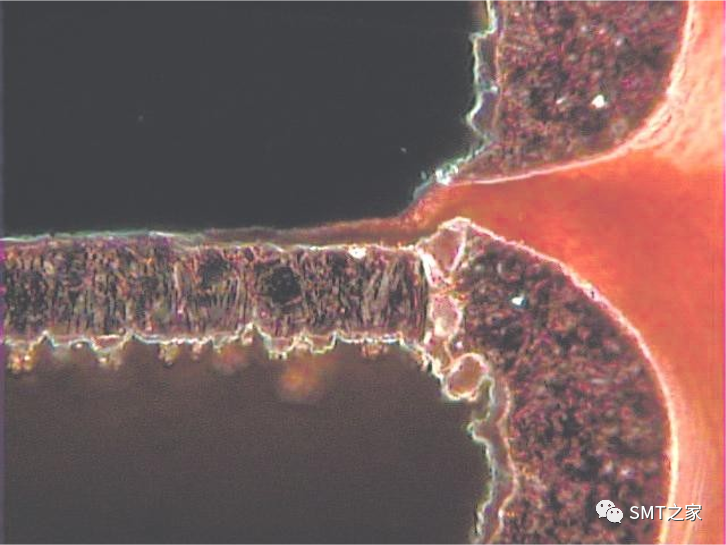
在价格压力与无铅化无卤化的技术剧变下,欧美寡占的CCL与PCB已逐渐转向亚洲 采购。系统厚大板类(High Layer Count),其Low Dk/Low Df与Low Insertion Loss等 需求已成为更上层楼的机会
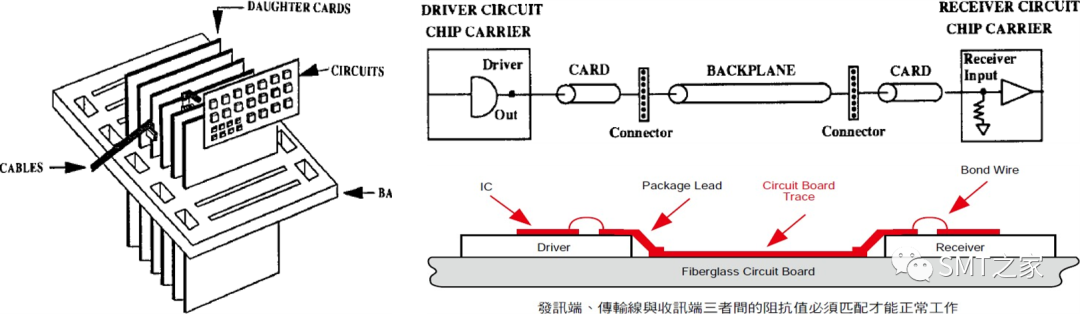


审核编辑:刘清

从profibusDP转ModbusTCP,一网打尽转换技巧!